在當今的電子設備領域,高功率、高頻的半導體器件如GaN高電子遷移率晶體管(HEMT)正變得越來越重要。它們被廣泛應用于雷達系統、衛星通信、5G基站、可再生能源、電動汽車等領域。然而,隨著設備功率密度的不斷提高,散熱問題成為了制約其性能和可靠性的關鍵瓶頸。GaN HEMT器件在運行過程中會產生局部熱流密度,這些熱流密度可能比太陽表面還要高一個數量級,這不僅會降低設備的性能,還會縮短其使用壽命。因此,如何有效散熱成為了亟待解決的問題。
金剛石作為一種天然材料,擁有最高的熱導率,被認為是理想的散熱基底材料。然而,將金剛石與半導體材料進行有效集成一直是一個巨大的挑戰。目前,主要有兩種方法:金剛石沉積和金剛石鍵合。金剛石沉積方法雖然能夠成功制備出4英寸的GaN-on-Diamond晶圓,但由于在SiN介質層上沉積的金剛石晶體質量較低,導致其熱導率受限。而金剛石鍵合方法則提供了更大的靈活性,可以通過優化界面特性來降低熱邊界電阻。
研究概述
本文的核心內容是關于如何將多晶金剛石(PCD)與3C-SiC直接集成,以增強GaN HEMT的熱管理能力。研究團隊通過一種先進的鍵合技術,成功地將 PCD與3C-SiC在室溫下直接鍵合,并在2英寸的PCD晶圓上實現了GaN HEMT的集成。這一成果不僅克服了PCD表面粗糙度高的難題(表面粗糙度為2.48 nm),還通過退火處理將界面處的非晶層轉化為多晶SiC層,且在這一過程中沒有出現裂紋或分離現象。
如圖1所示,詳細描述了AlGaN/GaN/3C-SiC層的轉移過程以及在2英寸PCD晶圓上GaN HEMT的制備步驟。
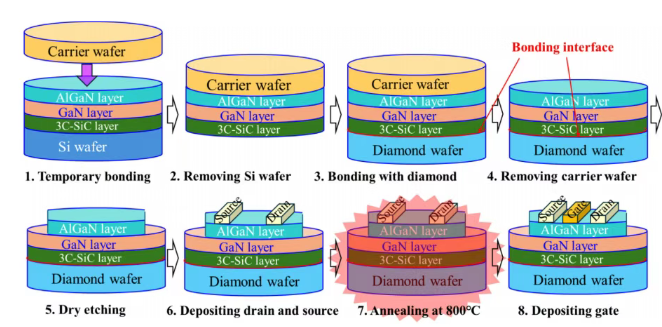
在2英寸PCD晶圓上GaN HEMT的制備步驟
在實驗過程中,研究人員首先在6英寸的 Czochralski(Cz)-Si(111)晶圓上通過金屬有機化學氣相沉積(MOCVD)生長了HEMT異質結構,包括 AlGaN/GaN/3C-SiC等多層結構。隨后,通過化學機械拋光和氟酸刻蝕等步驟,將3C-SiC層與PCD晶圓進行鍵合。鍵合過程中,使用了表面活化鍵合(SAB)方法,并通過氬快原子束(FAB)對PCD和3C-SiC的生長表面進行同時輻照,以實現高質量的鍵合。
研究總結
研究結果顯示,PCD的生長表面熱導率高于單晶金剛石(SCD),但在GaN HEMT上,PCD的熱阻(RTH)卻比SCD高出27%。這一現象歸因于 PCD 核化表面上較小的晶粒尺寸導致的聲子散射。通過去除細晶粒核化層,可以顯著增強散熱效果。此外,通過透射電子顯微鏡(TEM)和能量色散X射線光譜(EDS)分析,研究人員發現,在1100°C退火后,界面處形成了約13 nm厚的多晶SiC層,且界面結構完整,沒有出現裂紋或分離現象。
該研究成功地實現了PCD與3C-SiC的直接鍵合,這一成果不僅解決了PCD表面粗糙度高的問題,還為高功率電子設備的散熱提供了一種新的解決方案。通過優化晶粒尺寸和界面工程,可以進一步降低聲子散射,提高熱傳輸效率,從而充分發揮PCD在下一代高功率電子設備中的散熱優勢。


 手機資訊
手機資訊 官方微信
官方微信










 豫公網安備41019702003646號
豫公網安備41019702003646號